3D-Schaltkreis-Experten kommen nach Dresden
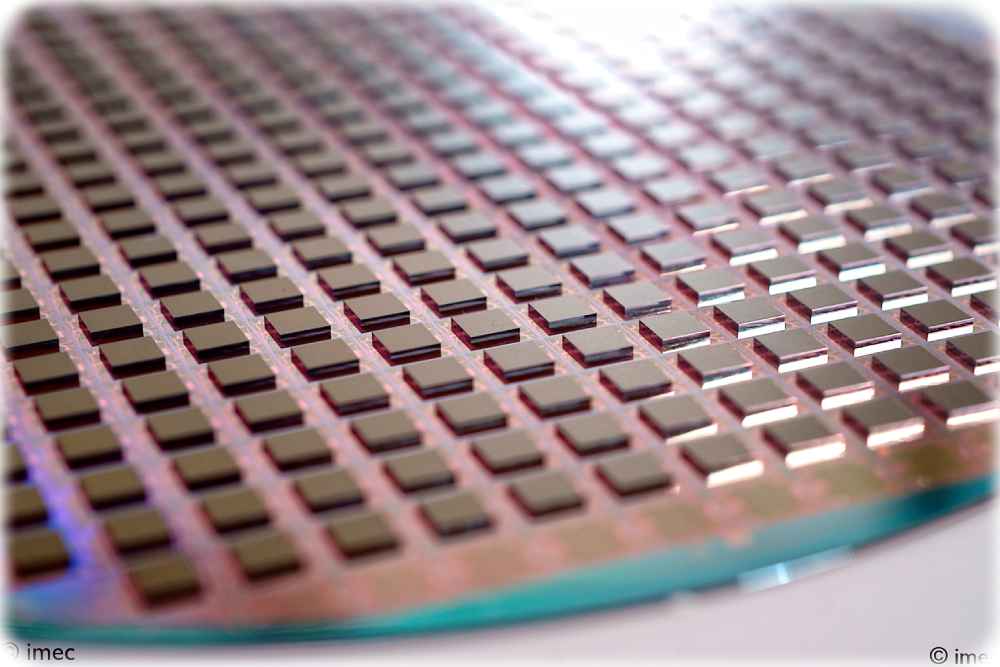
Heterogene Integration: Semi richtet Tagung über Kombination vieler Chips in einem aus
Dresden, 14. Juni 2023. Angesichts wachsender Probleme, Mikroelektronik so weiter zu miniaturisieren wie in früheren Dekaden, verpacken immer mehr Technologie-Unternehmen Prozessoren, Speicher, Sensoren und andere Chips in 3D-integrierten Systemen, die nach außen wie ein einziger Schaltkreis wirken. Unterm Strick erreichen sie damit eine höhere Leistungsdichte auf kleinstem Raum. Welche Technologien und Systeme sich dafür gerade durchsetzen, wollen internationale Halbleiter-Experten vom 26. bis 28. Juni 2023 auf Einladung des Branchenverbandes „Semi“ zur Konferenz „3D & Systems Summit – Intelligentere Systeme durch heterogene Integration“ in Dresden diskutieren.
Verpackungsinnovationen entscheidend für weiteres Wachstum in Halbleiterindustrie
„Verpackungsinnovationen sind für das Wachstum der Halbleiterindustrie von entscheidender Bedeutung“, betont Präsident Laith Altimime von „Semi Europe“. „Sie steigern die Chipleistung, senken den Stromverbrauch und ermöglichen kleinere Endgeräte für aufstrebende und wachsende Marktsegmente wie autonomes Fahren, 6G, Internet der Dinge (IoT), künstliche Intelligenz (KI) und maschinelles Lernen.“
Hybrides Verdrahten, Photonik und Chiplets
Unter den Referenten sind Ingenieure, Manager und Forscher von ASML, AMD, Siemens EDA, Audi, Yole, Süss Microtec und Racyics, aber auch von Forschungseinrichtungen wie dem Imec, dem Cea-Leti, den Fraunhofer-Institutsteilen EAS und Assid sowie der Forschungsfabrik Mikroelektronik Deutschland. Auf ihrer Agenda stehen unter anderem neue Verpackungstechnologien für Schaltkreise, die hybride Verdrahtung (Bonding), Chiplet-Design, die Integration photonischer Funktionen in die Chips und generelle Markttrends bei der 3D-Integration.
Europa knüpft noch an einem eigenen Ökosystem für 3D-Verpackungstechnologien
Hintergrund: Bisher beherrschen erst wenige internationale Branchenakteure Chiplet-Design und 3D-Integration vollends für die Massenproduktion. Dazu gehören insbesondere die „großen Drei“, also TSMC, Intel und Samsung. Europa baut gerade erst ein Ökosystem für diesen noch jungen Technologiepfad auf – und noch um eigene 3D- und Chiplet-Technologien für die Massenproduktion. Zu den Vorreitern in Sachsen gehören das EAS und das Assid.
Autor: Heiko Weckbrodt
Quellen: Semi, Oiger-Archiv

Ihre Unterstützung für Oiger.de!
Ohne hinreichende Finanzierung ist unabhängiger Journalismus nach professionellen Maßstäben nicht dauerhaft möglich. Bitte unterstützen Sie daher unsere Arbeit! Wenn Sie helfen wollen, Oiger.de aufrecht zu erhalten, senden Sie Ihren Beitrag mit dem Betreff „freiwilliges Honorar“ via Paypal an:
Vielen Dank!

