Um sehr dünne Schichten zu erzeugen, die zum Beispiel die Reibung eines Motorzylinders mindern, einer Siliziumscheibe neue Computerchip-Elemente zufügen oder ein Feuerwehrhelm-Visier gegen Hitze und gleißende Helle schützen, gibt es verschiedene Verfahren, die alle ihre Vor- und Nachteile haben. Solche Dünnschichten lassen sich beispielsweise durch Lichtbögen, Elektronenstrahlen oder durch Kathodenzerstäubung („Sputter“) erzeugen.
Eine weitere Möglichkeit ist die sogenannte Atomlagen-Abscheidung, englisch „Atomic Layer Deposition“ (ALD) genannt. Dieses Verfahren gilt zwar als eher langsam, aber auch als sehr präzise: Wie es der Name schon andeutet, lassen sich damit sogar Schichten erzeugen, die nur eine einzige Atomlage dünn sind. Entwickelt wurde diese Technologie in den 1960ern in der Sowjetunion und in den 1970ern in Finnland. Heute wird die ALD vor allem in Halbleiter-Fabriken eingesetzt. Und das funktioniert so:
Ablauf
Erster Schritt: Ein Roboter oder ein Mensch füllt eine Vakuumkammer mit Siliziumscheiben („Wafer“). Ist die Kammer verschlossen, füllt sie sich mit einem der Reaktionsstoffe („Präkursor“), zum Beispiel mit Hafniumchlorid oder Tantalchlorid. In unserem Beispiel bleiben wir bei Hafnium. Dieser Präkursor reagiert dann mit Hydroxid-Ionen (OH-) auf der Oberfläche des Wafers. Dieses Hydroxid ähnelt dem Wassermolekül, hat aber pro Sauerstoff-Atom nur ein statt zweier Wasserstoff-Atome gebunden. Daher ist Hydroxid sehr reaktionsfreudig. So kann im ersten Schritt sehr leicht eine Schicht aus dem eingeleiteten Hafniumchlorid wachsen – aber eben nur so lange, bis die OH-Gruppen aufgebraucht sind. Dadurch wuchert die Schicht auch nicht unerwünscht weiter hoch.
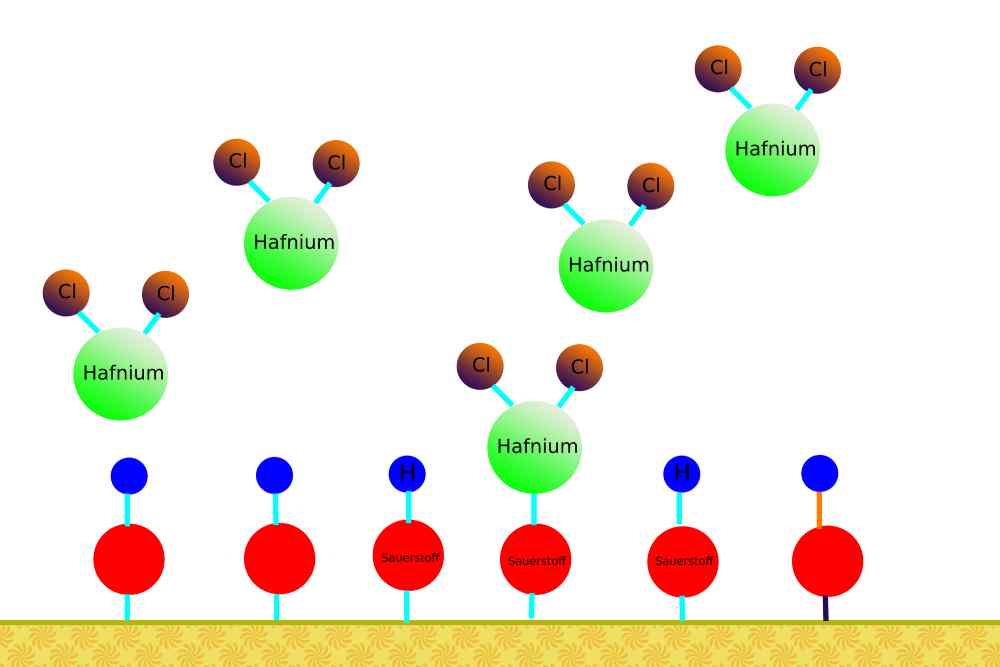
Atomlagenabscheidung: Auf einer Oberfläche mit angehefteten OH-Molekülen lagert sich zum Beispiel Hafniumchlorid ab. Grafik: Heiko Weckbrodt
Im zweiten Schritt flutet die ALD-Anlage die Kammer mit einem Edelgas wie Argon, das so gut wie überhaupt nicht mit anderen Stoffen reagiert. Das Argon spült überflüssiges Hafniumchlorid hinaus.
Im dritten Schritt wird Wasser als neuer Reaktionsstoff eingeleitet. Die Wasserstoffatome im Wasser verbinden sich nun mit dem Chlor aus dem Hafniumchlorid zu Salzsäure. Übrig bleibt eine hauchdünne Lage von nur etwa einem Fünftel Nanometer (Millionstel Millimeter) aus Hafniumoxid-Molekülen auf dem Wafer zurück sowie obendrauf neue Hydroxid-Moleküle, die auf den nächsten Durchlauf warten.
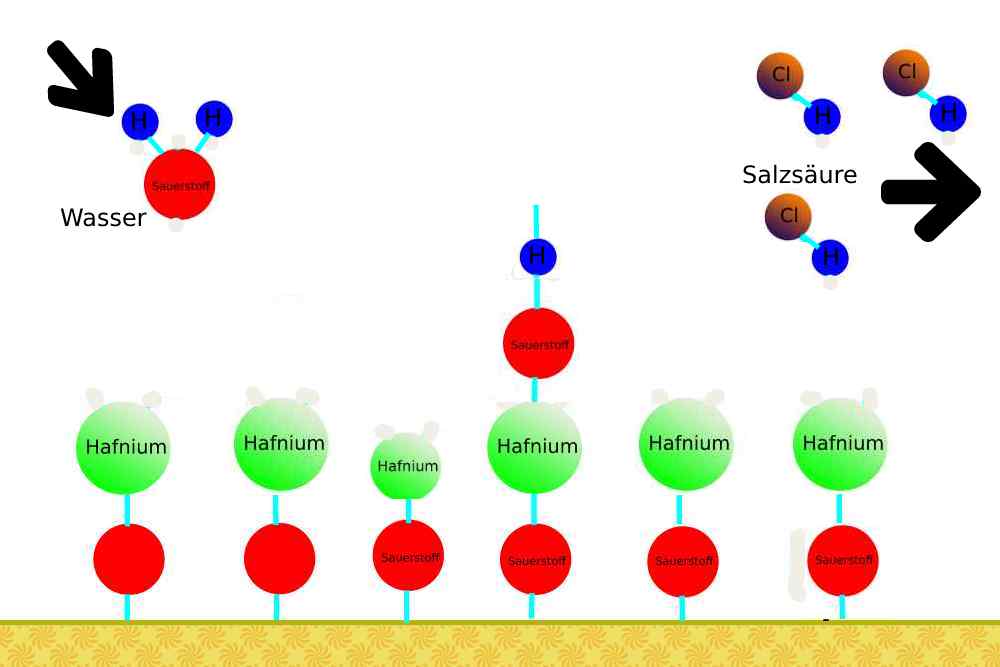
Atomlagenabscheidung: Nach einem Spülvorgang mit einem Edelgas wird Wasser eingeleitet und es bildet sich wieder eine Shicht aus reaktionsfreudigen Hydroxiden, während sich Chlor und das andere Wasserstoffatom zu Salzsäure verbinden und ausgespült werden. Nach einer weiteren Edelgasspülung kann der Prozess von vorn beginnen. Grafik: Heiko Weckbrodt
Im vierten Schritt spült Argon die Salzsäure und das überschüssige Wasser aus der Kammer und der Zyklus beginnt von vorn.
Vor- und Nachteile
Mit dieser Methode entstehen sehr präzise, gleichmäßig verteilte und dünne Schichten auf dem Wafer. Wegen der vielen Zwischenschritte und insbesondere der Argon-Spülungen dauert es aber ziemlich lange, um dickere Schichten von einigen Dutzend Nanometern zu erzeugen, bevor der nächste Wafer eingelegt werden kann – teils mehrere Minuten, teils sogar über eine halbe Stunde.
Autor: Heiko Weckbrodt
Quellen: FHR, Wikipedia, TU Freiberg

Ihre Unterstützung für Oiger.de!
Ohne hinreichende Finanzierung ist unabhängiger Journalismus nach professionellen Maßstäben nicht dauerhaft möglich. Bitte unterstützen Sie daher unsere Arbeit! Wenn Sie helfen wollen, Oiger.de aufrecht zu erhalten, senden Sie Ihren Beitrag mit dem Betreff „freiwilliges Honorar“ via Paypal an:
Vielen Dank!

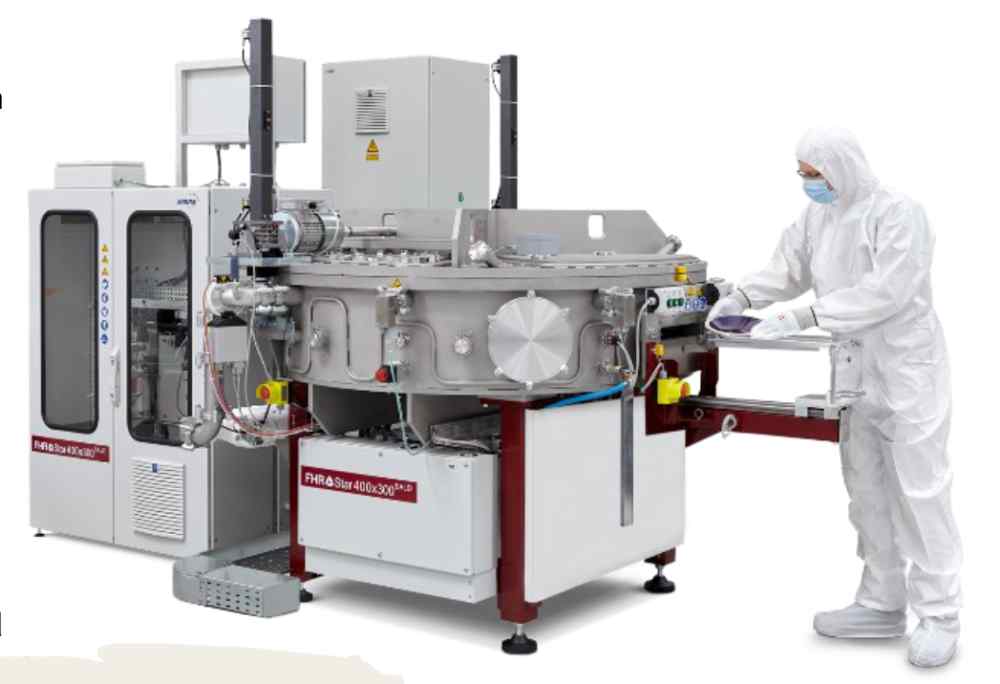
Du muss angemeldet sein, um einen Kommentar zu veröffentlichen.